ダイヤモンドAFMプローブを用いたナノ計測一体型超微細加工システムの開発
- ホーム
- 研究紹介
- マイクロ・ナノ構造創成技術
- ダイヤモンドAFMプローブを用いたナノ計測一体型超微細加工システムの開発
- ダイヤモンドAFMプローブを用いた
ナノ計測一体型超微細加工システムの開発 - 微細パターニングを実現する
ダイレクトインプリントリソグラフィ技術 - Ni電鋳金型を用いたマイクロインプリント技術
- マイクロニードルアレイ工具を用いた
高品位・高能率マイクロ穴加工技術 - マイクロニードルアレイを用いた
マスクレス微細めっきパターン形成技術
ダイヤモンドAFMプローブを用いたナノ計測一体型超微細加工システムの開発
原子間力顕微鏡(AFM)は,非接触・実空間で原子・分子像を直接観察できる精度を有し, かつ摩擦力,粘弾性,硬さなどの機械的特性や電気的,磁気的,熱的特性をナノメータレベルの空間分解能で評価できる強力なツールです.しかも,機械的加工(押込みやスクラッチングなど)や探針-試料間に電圧を印加することによって リソグラフィ,電界加工,CVD,蒸着などの超微細加工・薄膜形成にも応用が可能な優れた技術です.しかし,産業分野での実用化を図るためには,再現性・制御性に優れ,かつ生産性の高いナノ加工・計測技術としての確立が 重要となります.このためには,従来から用いられているシリコン(Si)や窒化シリコン(Si3N4)製 のプローブでは,探針先端の摩耗が問題となり,計測データの信頼性や加工の再現性などが得られず実用的とは言えません.そこで本研究室では,将来のナノテクノロジーを支援する革新的な製造技術の一つとして, ナノメートルレベルの微細加工が行え,かつナノ形状計測・表面物性評価機能(AFM機能)を同時に有する “ナノ計測一体型超微細加工システム”の開発を行っています.
これまでに,気相合成ダイヤモンド膜のマイクロマシニング技術を確立し, 走査型トンネル顕微鏡(STM)の計測機能と微細加工用ツールとしての性能を同時に有する半導体ダイヤモンド探針(図1)や 高硬度・耐摩耗性に優れたダイヤモンドAFMプローブ(図2)の開発を行ってきました.しかし,現状のダイヤモンド探針部は,異方性エッチングによって作製したSiモールドを利用するため, 図のようなピラミッド形状(対面角70.6o)となり,アスペクト比(=高さ/直径)の高い構造体の加工や計測が 行えないという問題がありました.そこで,反応性イオンエッチング(RIE)において,本来はエッチング耐性が要求される マスク材料を積極的に除去しながらダイヤモンド膜を加工することで,3次元的な微小構造体を創成する技術を開発しました.図3(左図)の例は,直径4μm,高さ12μm,先端角60o,先端径50nm程度のダイヤモンド構造体です.このように,高アスペクト比を有し,かつ先端部分のみを先鋭化したダイヤモンド構造体の創成が可能となりました.
現在,Siカンチレバー先端部にダイヤモンド構造体(探針)を一体形成する作製プロセスを検討しています(右図).
本提案技術によって,高アスペクト比を有する先鋭化ダイヤモンドAFMプローブの量産技術が確立できれば, 研究レベルにとどまっているAFM技術をベースとした最先端のナノ加工・計測技術が製造業においても利用可能となります.
例えば,①ナノメートルレベルの微細加工と,②AFM計測機能による加工前の表面性状の評価,加工場所の原子レベルでの位置決め,加工後の形状評価が同一の装置上で実現可能となります.さらには,③作製したデバイスの機械的,電気的,熱的な 物性値をナノメートルレベルの空間分解能でマッピングする機能も同時に備えた“多機能ナノ加工・計測技術”としての 高いポテンシャルを有しています.このため,超LSIの検査・評価技術,次世代超LSIのリソグラフィ技術,フォトマスクの リペア加工技術,MEMS/NEMSなどの3次元ナノ構造創成技術などへの応用が期待できます.
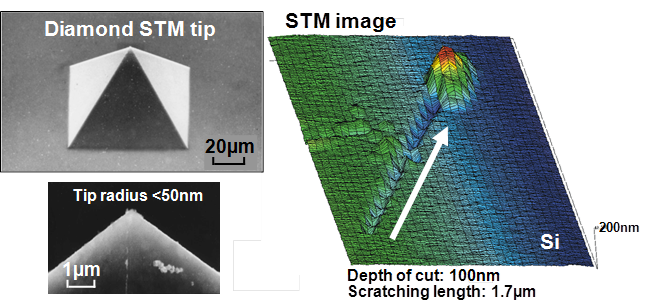
図1 半導体ダイヤモンド探針(左図)によってSi表面に形成したスクラッチ加工痕と同探針を用いて観察したSTM像(右図)
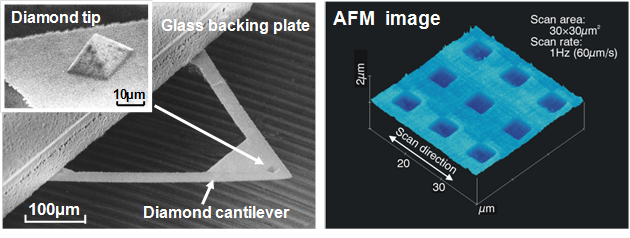
図2 ダイヤモンドAFMプローブ(左図)と取得したAFM像(右図)
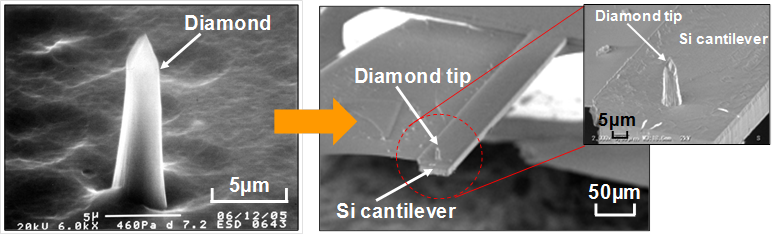
図3 反応性イオンエッチング(RIE)によって作製した高アスペクト比をもつ先鋭化ダイヤモンド構造体(左図)とSiカンチレバー上に一体形成したAFMプローブの試作例(右図)
関連論文:
[1] T. Shibata et al., Proceedings of euspen 2009 conference, San Sebastian, Spain, Vol. II, pp.162-165, 2009.
[2] T. Shibata, Diamond MEMS Sensors, in: C.A. Grimes, E.C. Dickey, M.V. Pishko (Eds.), Encyclopedia of Sensors, Vol. 2, American Scientific Publishers, California, USA, pp.349-368, 2006.
[3] T. Shibata et al., Sens. Actuators A, 114 (2-3), pp.398-405, 2004.
[4] T. Shibata et al., Sens. Actuators A, 102 (1-2), pp.106-113, 2002.
[5] K. Unno et al., Smart Mater. Struct., 10 (4), pp.730-735, 2001.
[6] K. Unno et al., Sens. Actuators A, 88 (3), pp.247-255, 2001.
[7] T. Shibata et al., J. Microelectromech. Syst., 9 (1), pp.47-51, 2000.
共同研究先:
弘前大学 牧野英司 教授
山形大学 峯田 貴 教授
協力企業:
住友電気工業株式会社